最近遇到一个问题--大面积银烧结(Large area sintering,LAS)可行性,本着不懂就学的理念,今天我们就来聊一聊这个话题。
前言
首先,为了发挥碳化硅的优异性能,传统硅基的模块封装在不断地发展,新的封装材料和技术在不断地被挖掘。其中,新的封装形式得属车规的花样最多,但都涉及到一个技术--银烧结。低温银烧结技术由Schwarzbauer开创,最初使用的是薄银片,但由于其较低的扩散能力,需要施加约30~80MPa的高烧结压力来实现较为坚固的烧结。
烧结银的熔点约为961℃,导热系数约240W/m·K(约为传统焊料的3倍),抗剪切强度能够达到70Mpa,强于大多数焊料,所以,银烧结以其优异的散热性能和高温可靠性成为碳化硅应用中很受欢迎的技术。但较大的烧结压力需要昂贵的设备,这导致了模块生产成本的增加,所以不同的银膏材料也在不断地被研究,同时根据应用场景的不同,需要对于烧结过程中的多项参数进行不断优化,才能达到较为坚固可靠的烧结效果,这就引出来了今天的话题,大面积银烧结的可行性。
目前我们可以在很多模块(工业和车规都有)中看到银烧结的身影,当然这也是每家必然会宣传的一个技术特点。但大多数都是芯片到陶瓷基板采用银烧结,芯片面积通常较小,大约几十mm^2的样子,所以小面积的银烧结技术算是比较成熟了吧。那么陶瓷基板烧结到底板或者壳体上呢?成熟的面积大点的算是TPAK在Tesla上的应用了吧,下面是TPAK银烧结到铝制壳体的截面图,
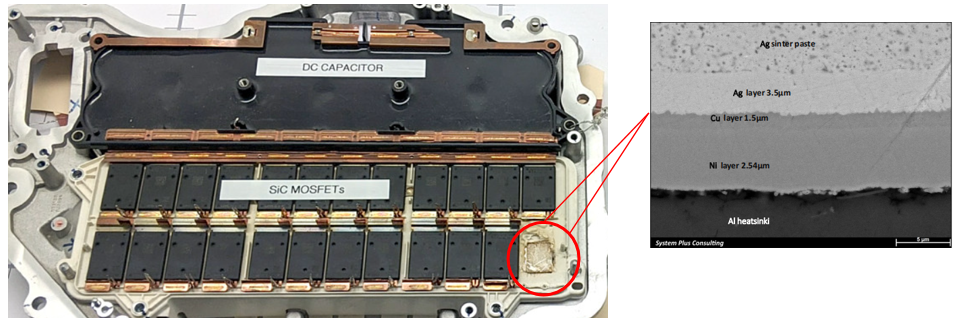
TPAK背面AMB的裸露面积大致在14mm*18mm=252mm^2左右,相对于芯片的几十mm^2来说算大了一点,但TPAK是单个开关,如果是常见的塑封半桥或者HPD里面的陶瓷基板面积呢,要怎么去评估呢?
其实,接下来我们也只是聊聊大面积银烧结工艺中影响烧结可靠性的几个主要因素,以及注意事项,具体的烧结参数,我觉得还需要结合实际烧结面积等来做调整和优化,寻找最优参数。
大面积银烧结讨论
以下内容主要基于一篇论文(Low-Pressure-Assisted Large-Area (>800mm2) Sintered-Silver Bonding for High-Power Electronic Packaging, Yan-Song Tan, Xin Li)展开,旨在了解大面积银烧结中主要因素的相互关系和注意事项。
银膏
首先,银膏采用的是球状纳米银颗粒和微银片组成,球状纳米银颗粒直径在30~60nm之间,银片具有不同形状,平均直径在1~3um,厚度100~300nm。电镜扫描如下,
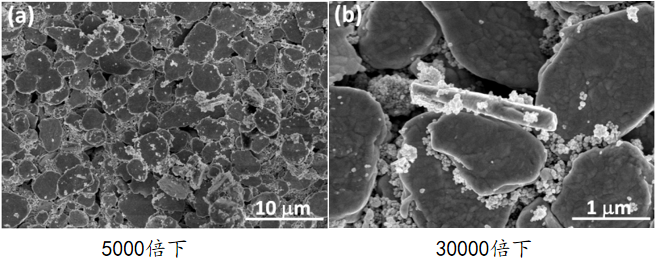
除了纳米银颗粒和银片之外,银膏中还分别添加了分散剂、粘合剂和稀释剂,为了确保颗粒的分散性/聚合物的稳定性、膏体的可印刷性和流动性。
银烧结过程介绍
银烧结过程可以分为四个阶段,如下,

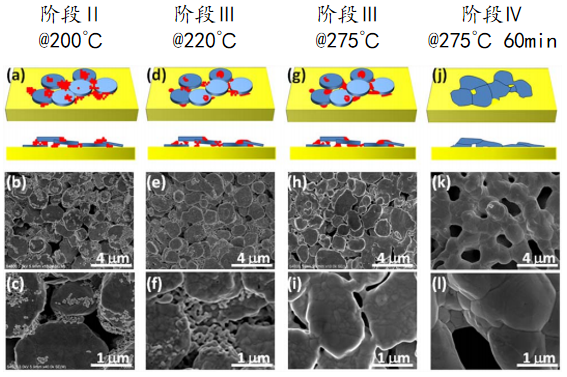
阶段Ⅰ
随着温度的升高,溶剂迅速蒸发,大多数溶剂在70~160℃下蒸发。随着溶剂的蒸发,附近具有高表面能的纳米银颗粒通过表面吸附在一起,形成纳米银团簇并附着在银片的表面或者之间,银糊状层开始收缩;
阶段Ⅱ
温度从160℃升到200℃,那些附着的纳米银颗粒倾向于旋转到相同的晶向,银片也试图通过相应烧结力的旋转和滑动来排列成更稳定的位置,整个系统都试着转换到一个低能量的配置。在银片重排过程中,纳米颗粒间接触增加,在银片间形成颈部,纳米银颗粒逐渐聚集和致密化。(如果未发生致密化,可能是仍有分散剂的残留,包裹着纳米银颗粒表面,阻碍后者聚集)。
阶段Ⅲ
温度从200℃上升到220℃,分散剂被破坏,纳米银颗粒迅速聚集,银片之间烧结颈随着温度升高而增大,实现银片之间的初步连接,这一过程,银片形状没有明显变化。在275℃时我们已经无法区分纳米银颗粒的边界,烧结颈变得更强。
阶段Ⅳ
温度保持在275℃,银片已经发生剧烈烧结,从而产生了进一步的致密化。保持60min后,这些纳米级烧结颈和银片完全消失,烧结完成。
大面积烧结的挑战
我们的目标是烧结成具有紧密界面接触,无裂纹和高粘结强度的大面积烧结银。
①很难在润湿性和表面接触之间保持平衡(溶剂去除)
从上图阶段Ⅰ可以看出,有机溶剂的占比约为10%,这些溶剂需要在烧结行为发生前蒸发或者燃烧掉,有两种方法。
a.在底部基板上印刷湿膏,将顶部基板安装到印刷后的湿膏上,由于银膏是湿润的,没有任何预干过程,这样很容易形成初始的表面接触。但去除溶剂就需要很长一段时间,尤其对于大面积而言,如果溶剂没有及时去除,一旦温度达到其沸点,溶剂便会沸腾,很容易在银烧结中形成大量的裂纹。
b.进行预干,但如果银膏被预先干燥,将很难形成亲密的表面接触,这时候需要一个大于10Mpa的压力,这样便会增加成本。
②何时施加压力
施加压力有助于大面积的粘合,但如果压力施加过早,银膏仍被大量溶剂湿润着,此时压力可能会挤压出一些银膏,并且溶剂的蒸发也将变得困难;
其次,对于大面积而言,内部银膏中的溶剂比外部去除的要慢,如果压力太晚,外部银膏可能会过于干燥,很容易形成局部分层。
所以何时施加压力是个关键问题。
影响因素
文中烧结面积为41mm*23mm=943mm^2,衬底表面镀有10um的银膜以放止烧结中铜的扩散。烧结过程如下,

首先,在底部的衬底上用模板印上一个80μm厚的银膏。然后,将带有印刷湿膏的底部衬底放在热板上,通过温度斜坡速率从室温干燥至120°C。在120°C下的浸泡时间为90 min。干燥和冷却后,在第二层薄薄的第一层膏的顶部模板印上银膏。然后,将顶部的基板安装在第二层湿糊体上。薄的第二层湿糊用于确保安装的顶部基板和干燥的第一层糊之间的亲密表面接触。如果第二层糊太厚,就会引入更多的溶剂,存在形成裂纹的风险,所以这里选择的厚度为15~20um。放置在热压机(可加热可加压),温度以R0℃/min上升到T1,立即施加P1 MPa的压力,然后以R1℃/min加热到275℃,并保持60min。
改变参数:压制温度、压力大小和加热速率,一共7个样品。

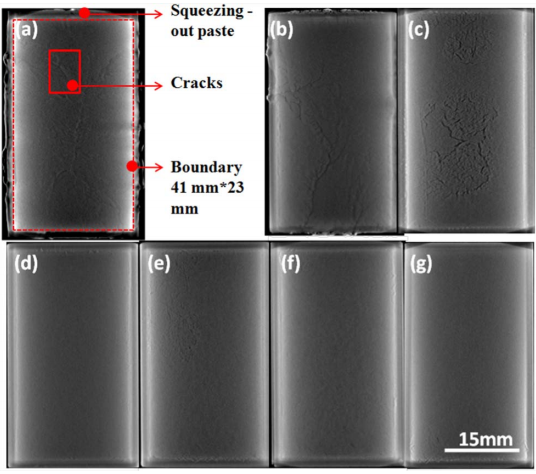
样品1,常温下加压,有银膏溢出,同时还存在裂纹,这会影响电热性能,降低抗剪切强度,还会导致局部热阻的急剧增大;
样品2同样有银膏溢出及裂纹;
样品3,没有银膏溢出,但是由于R1速率过快导致出现裂纹;
样品4~7都是OK的,样品4~6只是加压时的温度T1不同,样品5和7是施加的压力大小不同。样品5的烧结层厚度为56um(2.8MPa),平均孔隙率15.6%,样品7为64um(1.8MPa),平均孔隙率17.6%。但孔径大小占比不一样,

可以看出,压力越大小孔径占比越高,也就是说烧结更加致密。
剪切力测试,样品4/5/6分别为58.2/59.3/65.3MPa,即温度越高,剪切力越大;样品5和7分别为59.3和56.1MPa,即压力越大,剪切力越大。对于同一样品剪切力空间分布的变化,可能是镀银基板平整度不好或者银膏印刷不平整。
小结
以上我们讨论了大面积银烧结的几个主要因素,温度、压力和加热速率对于烧结质量的影响。针对不同面积和不同的银膏,可能以上参数都需要进行调整和优化,所以大面积银烧结的可行性更倾向于结合实际应用。
但银烧结带来的优异性是无可厚非的,大面积的银烧结值得去尝试,相信已经有一些厂家,不管是模块厂商还是电驱厂家都已经在路上了。















暂无评论